自博通(Broadcom)官網獲悉,博通公司宣布推出其3.5D eXtreme Dimension系統級(XDSiP)封裝平臺技術。這是業界首個3.5D F2F封裝技術,在單一封裝中集成超過6000mm²的硅芯片和多達12個HBM內存堆棧,以滿足AI芯片的高效率、低功耗的計算需求。
本文引用地址:
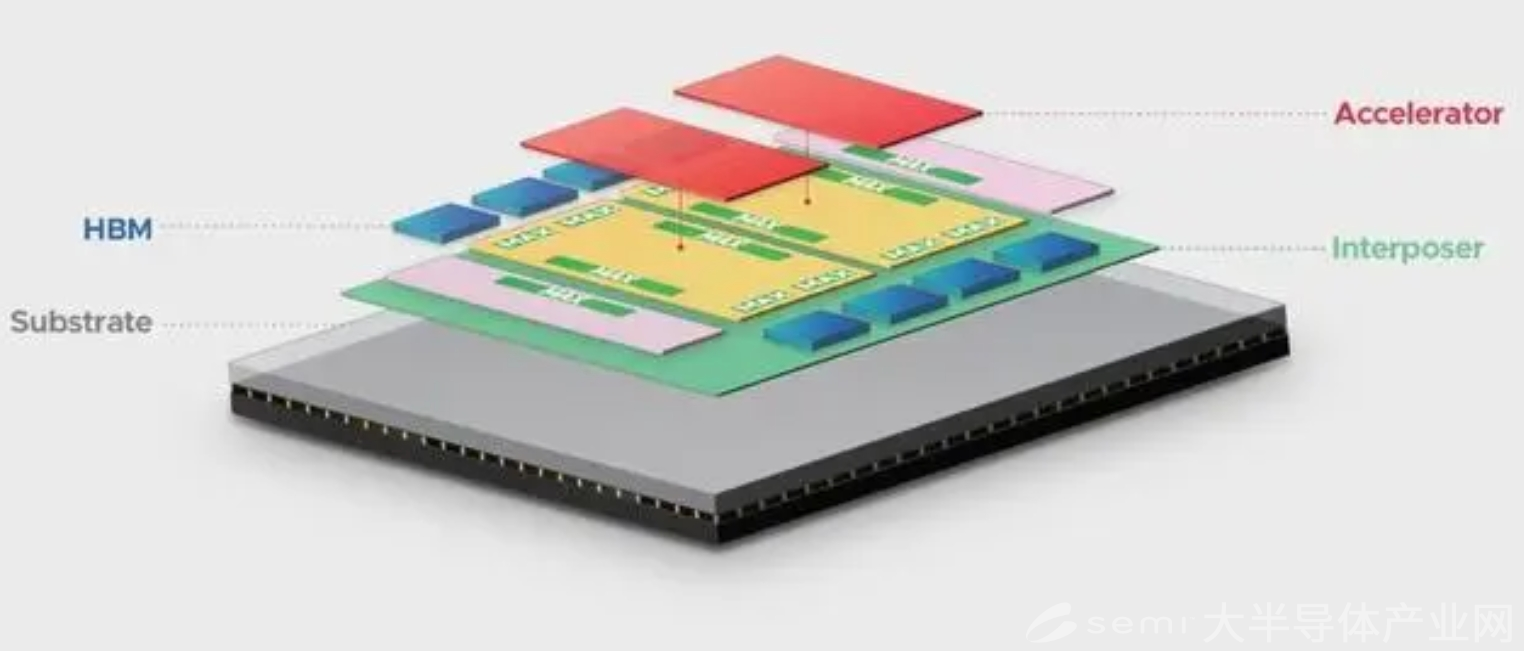
Broadcom 3.5D XDSiP的關鍵優勢
增強的互聯密度:在堆疊的芯片之間實現了比F2B技術高7倍的信號密度。
更高的功率效率:通過使用3D HCB而不是平面的芯片間PHY,將芯片間接口的功耗降低了10倍。
降低延遲:在3D堆疊中,最小化了計算、內存和I/O組件之間的延遲。
緊湊的封裝尺寸:使互連器和封裝尺寸更小,從而節省成本并改善封裝翹曲。
博通領先的F2F 3.5D XPU集成了四個計算芯片、一個I/O芯片和六個HBM模塊,利用臺積電先進的工藝節點和2.5D CoWoS®封裝技術。博通基于行業標準工具的專有設計流程和自動化方法學確保了芯片的首次成功,盡管其極為復雜。3.5D XDSiP已在關鍵IP塊(包括高速SerDes、HBM內存接口和芯片間互連)上展示了完整的功能和出色的性能。這一成就凸顯了博通在設計和測試復雜3.5D集成電路方面的專業技能。
